新品发布 | AI重构数据中心,GPU散热如何破局?
继OpenAI公司推出ChatGPT之后,DeepSeek-V3和R1两款大模型再度在海内外引发轰动,AI技术创新和普惠应用迈入新阶段。随着AI应用的蓬勃发展,其算力底座数据中心面临全新挑战,以满足智算发展需求。数据中心架构正加速向高密度、智能化和可持续方向演进。作为其中的“高性能引擎”,AI服务器以其异构计算架构、分布式扩展等特性为智算提供了有力支撑,但更高的功率密度使得其搭载的GPU芯片等核心硬件的散热问题愈发严峻。高可靠、高性能的散热解决方案已成为核心需求。

当前,芯片散热主要考虑外部系统散热技术和导热界面材料两个方面。从外部系统来看,在功率密度上升和节能目标的双重倒逼下,AI发展正加速推动液冷技术代替传统风冷成为制冷系统主流。其中,单板式液冷因节能优势更突出、技术更成熟,在液冷数据中心的应用达90%以上。从导热界面材料来看,技术快速更新的应用场景则对导热界面材料提出了更严苛更全面的要求。
挑战一
GPU在高性能计算中会产生大量热量,尤其是在深度学习、图像处理等任务中热量密度极高。其散热设计功耗已超过800W,传统有机硅体系的导热材料难以满足需求。
挑战二
冷板式液冷等制冷系统带来了更高的散热效能,界面热传导效率则是决定性的“最后一毫米”战场。在AI服务器等0.1mm以下的低BLT应用场景,需要导热界面材料具备更低的热阻和优异的填隙能力以进一步提高热传导效率。
挑战三
既要“薄”,也要“稳”。随着芯片尺寸扩展、单卡功率增高,热应力翘曲呈增大趋势,加之数据中心不间断运行的长期高温环境,需要导热界面材料具备优异的的长期可靠性,以解决日益突出的老化变干、pump out等问题。

芯片翘曲挤压导热界面材料,材料内聚力不足产生pump out
针对这一工况,泰吉诺创新研发超薄导热界面材料Fill-TPM 800,专为大功率大尺寸场景带来越来越大的翘曲问题提供高可靠的TIM1.5导热解决方案。Fill-TPM 800可在-40℃至125℃宽幅温度区间实现超薄填充贴合、高效精准导热,同时具有极低的热阻,特别适用于算力芯片、IGBT模组等应用场景,在风冷、冷板式液冷等制冷系统的装配压力下,均有着优异的导热性能表现。基于独特的配方设计,Fill-TPM 800进一步强化长期可靠性,更高的内聚力可有效防止因大尺寸芯片翘曲及面内发热不均所产生的pump out现象。

产品特点
极低热阻,满足增长的散热需求
低BLT应用中,界面热阻比起导热系数对散热效率有着更大的影响。
Fill-TPM 800随温度的升高逐渐变软,在较低压力下可达到低BLT,并充分填充界面间隙,有效降低界面热阻。在40psi下,Fill-TPM 800对比目前主流的高可靠性导热材料石墨烯,具有明显的热阻优势,极低热阻媲美高性能相变化材料与高端硅脂材料。

更高内聚力,强化长期可靠性
Fill-TPM 800采用非硅系基材,无硅污染。独特配方设计使其具有更高的内聚力及自修复能力,应对日益严峻的老化变干、pump out等可靠性问题。与同样适用于超薄界面、有着极低热阻的相变化材料、硅脂相比,Fill-TPM 800优异的内聚力使其在长期表现上更为可靠。

柔韧自粘片材,易于操作和重工
Fill-TPM 800在室温下具有柔软的特性和表面自粘性,使其具有良好的施工性能和重工性,可以直接定位并粘贴在散热器或芯片表面。可根据客户需求,提供卷材、片材或者是裁切好的各种形状及尺寸,以满足不同应用需求。



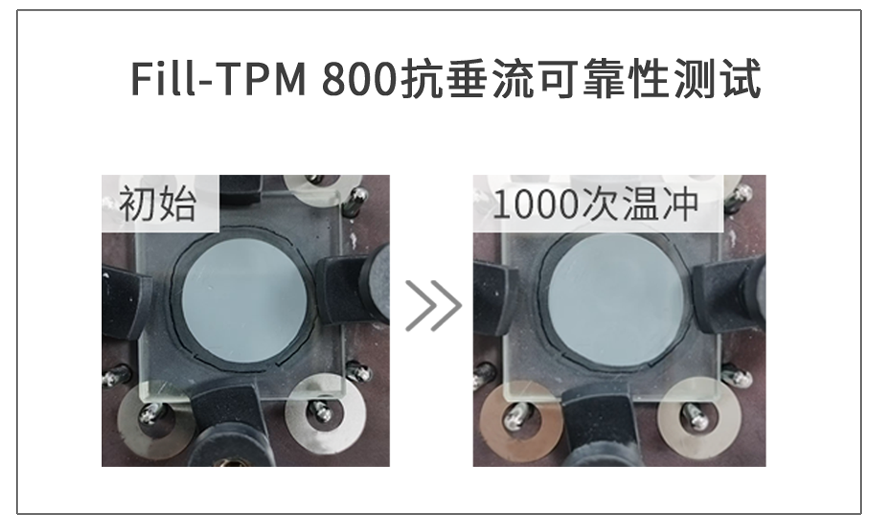
Fill-TPM 800在整个可靠性测试过程中热阻表现稳定, 在持续高温,高低温冲击以及双85测试条件下,Fill-TPM 800均能够保持其初始的热性能,没有出现导热性能下降的迹象。在抗垂流可靠性测试中,经-40℃~+125℃温冲1000次后,Fill-TPM 800没有出现开裂或下滑的情况,表现出了优异的抗下滑能力。
伴随着AI技术的飞速发展,AI算力系统所面临的散热挑战正加速升级。在液冷技术驱动外部系统革新的同时,导热界面材料端亟需更高性能的解决方案。泰吉诺Fill-TPM 800为冷板式液冷及风冷系统带来了全新高性能导热解决方案;针对喷淋式、浸没式,冷却液与发热器件直接接触的场景,泰吉诺全面的液态金属产品矩阵则带来了多样化选择。未来,泰吉诺将在高效散热、可靠性、环保性等方面持续突破,以创新导热界面材料为智算发展注入强劲动力,助力全球智能化进程。










